HDI基本知识
HDI(高密度互连)PCB设计是满足现代电子设备小型化、高性能需求的关键技术。最新版IPC对其定义如下:
高密度互连(HDI) 印制板单面或两面每平方厘米平均有20个电气连接设计(每平方英寸有130个电气连接)。这些设计通常有导通孔(≤0.15mm[0.006in]),导体宽度和间距≤100um[0.004in]、SMT焊盘导通孔、和/或微导通孔用于在薄介质厚度上。
微导通孔 按照图1-3测量时,最大厚径比为1:1,终止在或穿过目标连接盘的,从其捕获连接盘箔到目标连接盘的距离(X)不超过0.25mm[0.00984in]的盲孔结构(电镀态的)。
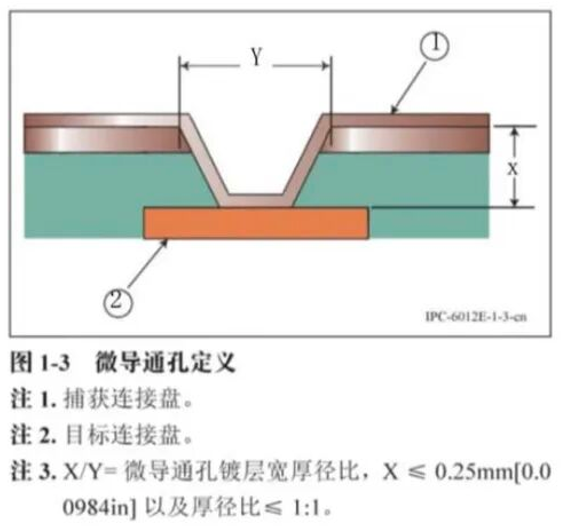
设计数据 提供给印制板制造商的数据,可能包括有关于最终产品性能、产品最终使用环境、产品结构、材料、元器件和工艺的机械信息、电气设计信息和要求。
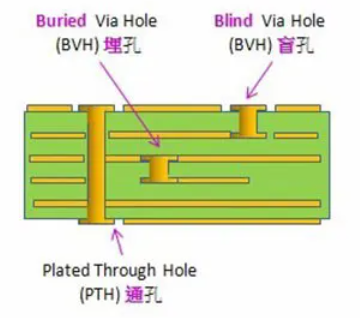
1.激光类型
紫外光 UV/Yag
红外光
CO2
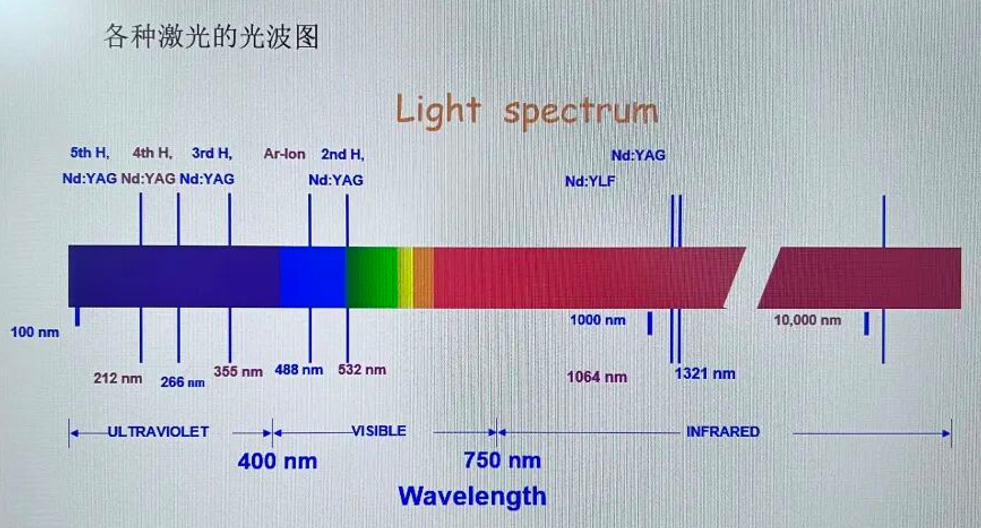
不同类型对应成品孔品质有差,如下图所示
: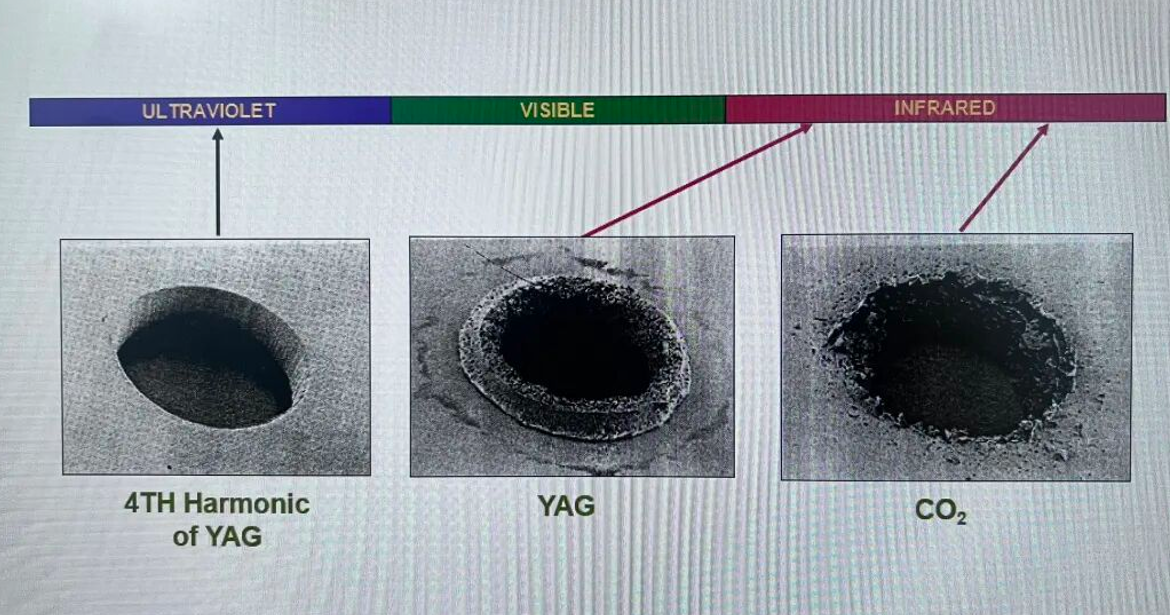
2.激光發生原理
激发介质:气体、固体、半导体等
激发能量:光能、电压、电流等
共鸣器:反射镜,折射镜
3.Microvia 的成孔原理
IR 与 UV LASER 的盲孔加工原理是不一样的:
IR——红外线是利用其光束所带的热能,将介质加热至熔融状态,并达到气化,最后除去成孔,从而形成Micro-via.
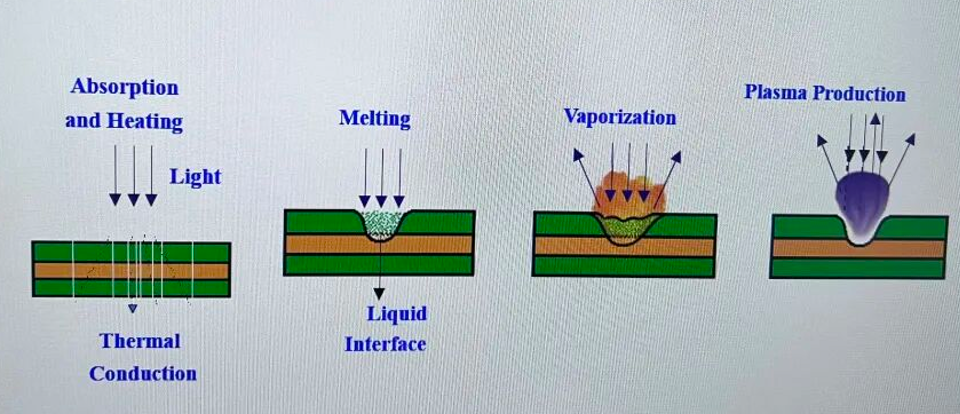
UV— 紫外线是利用其化学能,增加介质的原子能,使其从原来的分子逸出,从而将介质的分子链打断,最后形成microvia.
4. 激光成孔的几种作业方法
UV direct drill
流程:
先以内层标靶定位,UV镭射用高能量直接将外层铜打掉,然后再用低能量将残余树脂清除.
如下图图示:
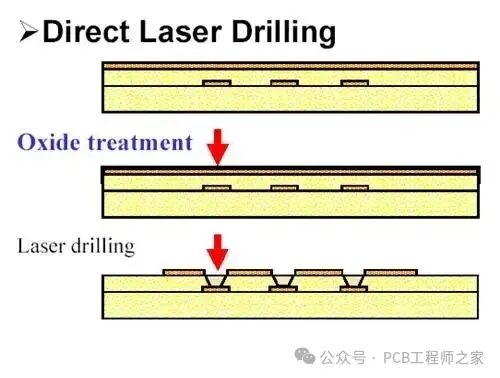
内层对位准确度高,过程简单.加工时间很长,若以加工8mil的孔为例,介质均为RCC,加工速度约10holes/second.
Uv laser会损伤底铜,增加电镀难度
UV + co2
流程:
先用UV Laser直接将外层铜打掉,然后用CO2 Laser消除残余树脂.
特点:
与内层对位精度高,可减少加工时间,而第二步用CO2 Laser,不易损伤底铜.
Conformal mask +co2
流程:
先做Conformal mask,然后用CO2 Laser清除残余树脂,如下图图示:
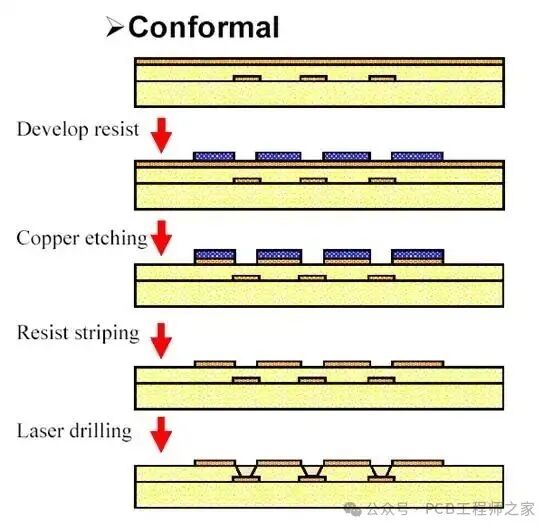
一阶HDI:最基础形式,外层有激光盲孔连接到相邻的次外层(L1-L2),通常一次层压。
二阶HDI:有两层激光钻孔层,可以是叠孔2阶,即 L1-L2有盲孔,L2-L3有盲孔,且L1-L2孔和L2-L3孔在垂直方向上堆叠。
错孔2阶: L1-L2和L2-L3有盲孔,但它们的位置交错开,可能一次或两次层压。
3阶HDI及以上: 有三层或更多激光钻孔层,结构更复杂,通常需要多次层压。
任意层HDI:每一层都是激光钻孔层,任何两层之间都可以直接互连(通过微孔),代表了最高的HDI水平(如智能手机主板常用的AnyLayer HDI)。










