SMT质量问题及解决方案超全汇总
现在,工程师做SMT贴片已经越来越方便,但是,对SMT中的各项工艺,作为工程师的你真的了解“透”了吗?本文整理了“五大SMT常见工艺缺陷”,帮你填坑,速速get吧!
缺陷一:“立碑”现象
立碑现象再流焊中,片式元器件常出现立起的现象。即片式元器件发生“竖立”。
立碑现象发生主要原因是元件两端的湿润力不平衡,引发元件两端的力矩也不平衡,导致“立碑”。

回流焊“立碑”现象图(来源网络)
什么情况会导致回流焊时元件两端湿润力不平衡,导致“立碑”?
因素A:焊盘设计与布局不合理
如果焊盘设计与布局有以下缺陷,将会引起元件两边的湿润力不平衡。
①元件的两边焊盘之一与地线相连接或有一侧焊盘面积过大,焊盘两端热容量不均匀;
②PCB表面各处的温差过大以致元件焊盘两边吸热不均匀;
③大型器件QFP、BGA、散热器周围的小型片式元件焊盘两端会出现温度不均匀。
解决办法:工程师调整焊盘设计和布局。
因素B:焊锡膏与焊锡膏印刷存在问题
①焊锡膏的活性不高或元件的可焊性差,焊锡膏熔化后,表面张力不一样,将引起焊盘湿润力不平衡。
②两焊盘的焊锡膏印刷量不均匀,多的一边会因焊锡膏吸热量增多,融化时间滞后,以致湿润力不平衡。一侧锡厚,拉力大,另一侧锡薄拉力小,致使元件一端被拉向一侧形成空焊,一端被拉起就形成立碑。
解决办法:需要工厂选用活性较高的焊锡膏,改善焊锡膏印刷参数,特别是钢网的窗口尺寸。
因素C:贴片移位Z轴方向受力不均匀
会导致元件浸入到焊锡膏中的深度不均匀,熔化时会因时间差而导致两边的湿润力不平衡,如果元件贴片移位会直接导致立碑。
解决办法:需要工厂调节贴片机工艺参数。
因素D:炉温曲线不正确
如果再流焊炉炉体过短和温区太少就会造成对PCB加热的工作曲线不正确,以致板面上湿差过大,从而造成湿润力不平衡。
解决办法:需要工厂根据每种不同产品调节好适当的温度曲线。
因素E:氮气再流焊中的氧浓度
采取氮气保护再流焊会增加焊料的湿润力,但越来越多的例证说明,在氧气含量过低的情况下发生立碑的现象反而增多;通常认为氧含量控制在(100~500)×10的负6次方左右最为适宜。
缺陷二:锡珠
锡珠是回流焊中常见的缺陷之一,它不仅影响外观而且会引起桥接。
锡珠可分为两类:一类出现在片式元器件一侧,常为一个独立的大球状(如下图);另一类出现在IC引脚四周,呈分散的小珠状。
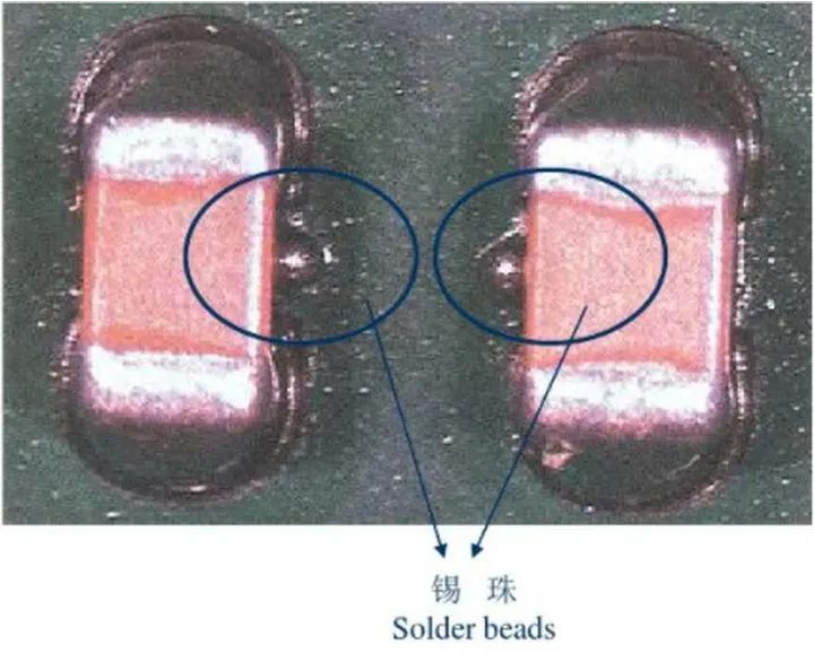
位于元器件腰部一侧(来源网络)
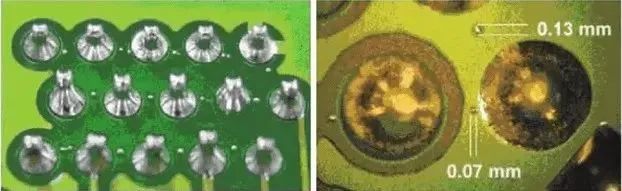
锡珠产生的原因主要有以下几点:
因素A:温度曲线不正确
回流焊曲线可以分为预热、保温、回流和冷却4个区段。预热、保温的目的是为了使PCB表面温度在60~90s内升到150℃,并保温约90s,这不仅可以降低PCB及元件的热冲击,更主要是确保焊锡膏的溶剂能部分挥发,避免回流焊时因溶剂太多引起飞溅,造成焊锡膏冲出焊盘而形成锡珠。
解决办法:工厂需注意升温速率,并采取适中的预热,使溶剂充分挥发。
因素B:焊锡膏的质量
①焊锡膏中金属含量通常在(90±0.5)℅,金属含量过低会导致助焊剂成分过多,因此过多的助焊剂会因预热阶段不易挥发而引起飞珠;
②焊锡膏中水蒸气和氧含量增加也会引起飞珠。由于焊锡膏通常冷藏,当从冰箱中取出时,如果没有充分回温解冻并搅拌均匀,将会导致水蒸气进入;此外焊锡膏瓶的盖子每次使用后要盖紧,若没有及时盖严,也会导致水蒸气的进入;
③放在钢网上印制的焊锡膏在完工后,剩余的部分应另行处理,若再放回原来瓶中,会引起瓶中焊锡膏变质,也会产生锡珠。
解决办法:要求工厂选择优质的焊锡膏,注意焊锡膏的保管与使用要求。
因素C:印刷与贴片
在焊锡膏的印刷工艺中,由于模板与焊盘对中会发生偏移,若偏移过大则会导致焊锡膏浸流到焊盘外,加热后容易出现锡珠。此外印刷工作环境不好也会导致锡珠的生成,理想的印刷环境温度为25±3℃,相对湿度为50℅~65℅。
解决办法: 仔细调整模板的装夹,防止松动现象。改善印刷工作环境。
因素D:贴片过程中Z轴的压力
是引起锡珠的一项重要原因,却往往不引起人们的注意。部分贴片机Z轴头是依据元件的厚度来定位的,如Z轴高度调节不当,会引起元件贴到PCB上的一瞬间将焊锡膏挤压到焊盘外的现象,这部分焊锡膏会在焊接时形成锡珠.这种情况下产生的锡珠尺寸稍大。
解决办法: 重新调节贴片机的Z轴高度。
因素E:模板的厚度与开口尺寸
模板厚度与开口尺寸过大,会导致焊锡膏用量增大,也会引起焊锡膏漫流到焊盘外,特别是用化学腐蚀方法制造的摸板。
解决办法: 选用适当厚度的模板和开口尺寸的设计,一般模板开口面积为焊盘尺寸的90℅。
其他因素还有:
①印刷太厚,元件下压后多余锡膏溢流;
②贴片压力太大,下压使锡膏塌陷到油墨上;
③焊盘开口外形不好,未做防锡珠处理;
④锡膏活性不好,干的太快,或有太多颗粒小的锡粉;
⑤印刷偏移,使部分锡膏沾到PCB上;
⑥刮刀速度过快,引起塌边不良,回流后导致产生锡球...
缺陷三:桥连
桥连也是SMT生产中常见的缺陷之一,它会引起元件之间的短路,遇到桥连必须返修。

BGA桥连示意图(来源网络)
造成桥连的原因主要有:
因素A:焊锡膏的质量问题
①焊锡膏中金属含量偏高,特别是印刷时间过久,易出现金属含量增高,导致IC引脚桥连;
②焊锡膏粘度低,预热后漫流到焊盘外;
③焊锡膏塔落度差,预热后漫流到焊盘外。
解决办法:需要工厂调整焊锡膏配比或改用质量好的焊锡膏。
因素B:印刷系统
①印刷机重复精度差,对位不齐(钢网对位不准、PCB对位不准),导致焊锡膏印刷到焊盘外,尤其是细间距QFP焊盘;
②钢网窗口尺寸与厚度设计失准以及PCB焊盘设计Sn-pb合金镀层不均匀,导致焊锡膏偏多。
解决方法:需要工厂调整印刷机,改善PCB焊盘涂覆层。
因素C:贴放压力过大
焊锡膏受压后满流是生产中多见的原因,另外贴片精度不够会使元件出现移位、IC引脚变形等。
因素D:再流焊炉升温速度过快,焊锡膏中溶剂来不及挥发
解决办法:需要工厂调整贴片机Z轴高度及再流焊炉升温速度。
缺陷四:芯吸现象
芯吸现象,也称吸料现象、抽芯现象,是SMT常见的焊接缺陷之一,多见于气相回流焊中。
芯吸现象使焊料脱离焊盘而沿引脚上行到引脚与芯片本体之间,通常会形成严重的虚焊现象。
产生原因:
通常是因引脚导热率过大,升温迅速,以致焊料优先湿润引脚,焊料与引脚之间的润湿力远大于焊料与焊盘之间的润湿力,引脚的上翘回更会加剧芯吸现象的发生。
解决办法:需要工厂先对SMA(表面贴装组件)充分预热后在放炉中焊接,应认真的检测和保证PCB焊盘的可焊性,可焊性不好的PCB不能用于生产,元件的共面性不可忽视,对共面性不好的器件不应用于生产。
注意:
在红外回流焊中,PCB基材与焊料中的有机助焊剂是红外线良好的吸收介质,而引脚却能部分反射红外线,故相比而言焊料优先熔化,焊料与焊盘的湿润力就会大于焊料与引脚之间的湿润力,故焊料不会沿引脚上升,从而发生芯吸现象的概率就小得多。
缺陷五:BGA焊接不良
BGA:即Ball Grid Array(球栅阵列封装)

正常的BGA焊接(来源网络)
不良症状①:连锡
连锡也被称为短路,即锡球与锡球在焊接过程中发生短接,导致两个焊盘相连,造成短路。
解决办法:工厂调整温度曲线,减小回流气压,提高印刷品质。
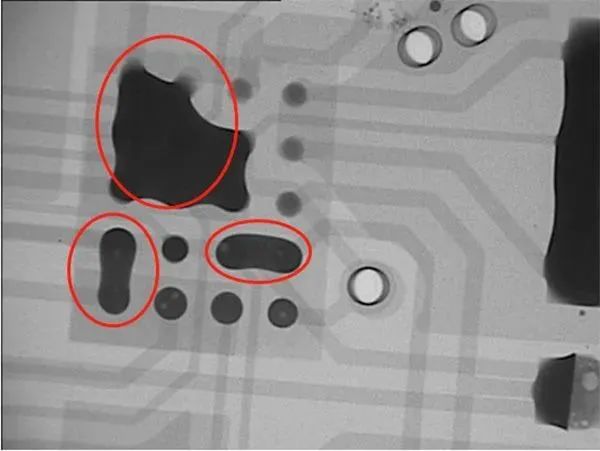
红圈部分为连锡(来源网络)
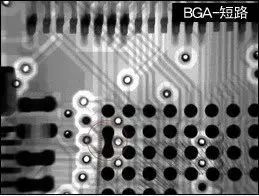
不良症状②:假焊
假焊也被称为“枕头效应(Head-in-Pillow,HIP)”,导致假焊的原因很多(锡球或PAD氧化、炉内温度不足、PCB变形、锡膏活性较差等)。BGA假焊特点是“不易发现”“难识别”。
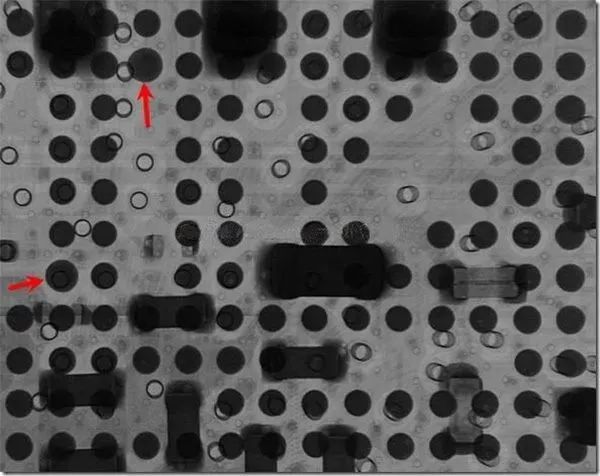
BGA假焊示意图(来源网络)
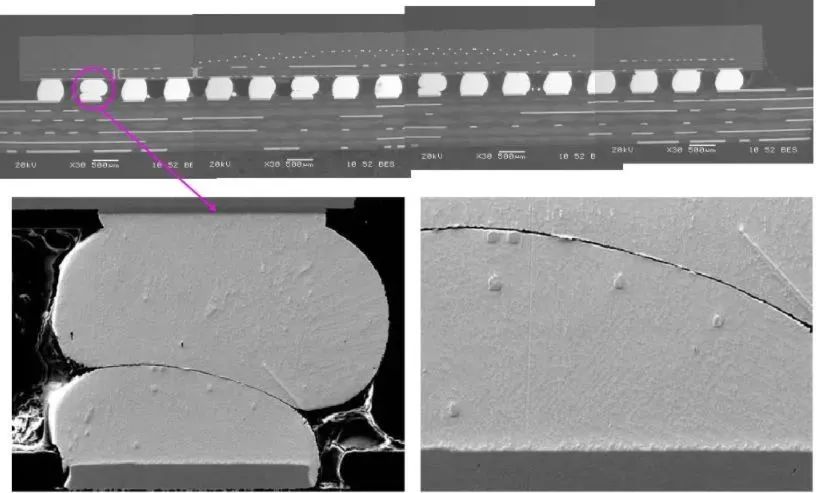
BGA“枕头效应”侧视图(来源网络)

不良症状③:冷焊
冷焊不完全等同与假焊,冷焊是由于回流焊温度异常导致锡膏没有熔化完整,可能是温度没有达到锡膏的熔点或者回流区的回流时间不足导致。
解决办法:工厂调整温度曲线,冷却过程中,减少振动。

BGA冷焊示意图(来源网络)
不良症状④:气泡
气泡(或称气孔)并非绝对的不良现象,但如果气泡过大,易导致品质问题,气泡的允收都有IPC标准。气泡主要是由盲孔内藏的空气在焊接过程中没有及时排出导致。
解决方法:要求工厂用X-Ray检查原材料内部有无孔隙,调整温度曲线。
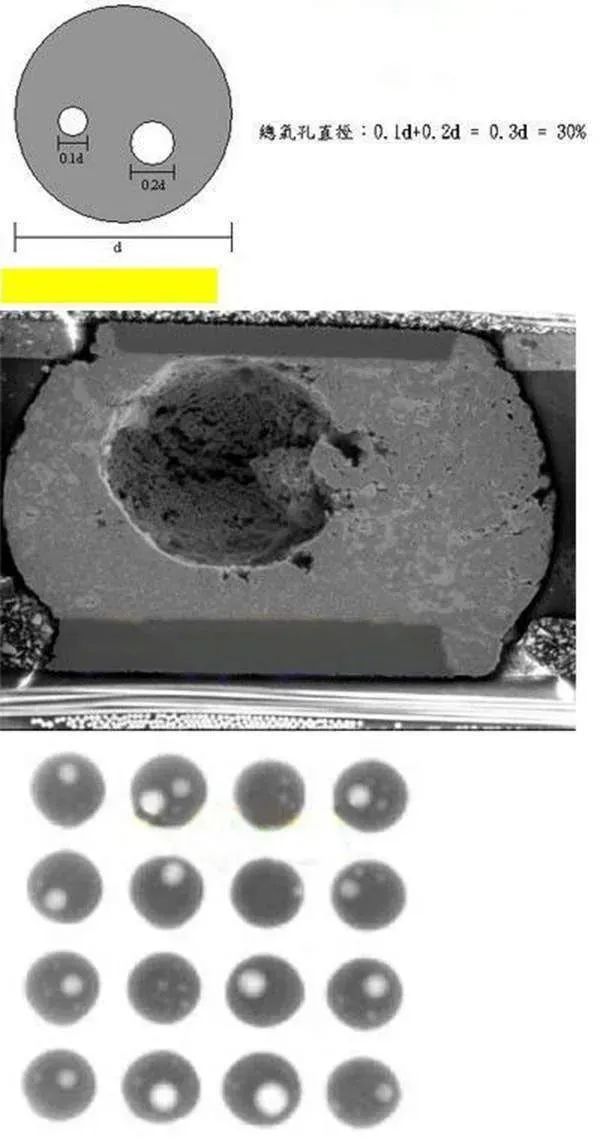
BGA气泡示意图(来源网络)

一般说来,气泡大小不能超过球体20%
不良症状⑤:锡球开裂
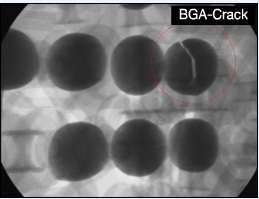
不良症状⑥:脏污
焊盘脏污或者有残留异物,可能因生产过程中环境保护不力导致焊盘上有异物或者焊盘脏污导致焊接不良。
除上面几点外,还有:
①结晶破裂(焊点表面呈玻璃裂痕状态);
②偏移(BGA焊点与PCB焊盘错位);
③溅锡(在PCB表面有微小的锡球靠近或介于两焊点间)等。
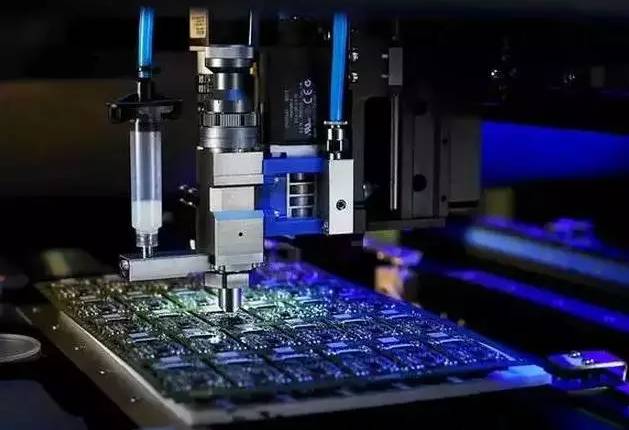
1、拉丝/拖尾
产生的原因常见有胶嘴内径太小、点胶压力太高、胶嘴离PCB的间距太大、贴片胶过期或品质不好、贴片胶粘度太好、从冰箱中取出后未能恢复到室温、点胶量太大等。
解决办法: 改换内径较大的胶嘴;降低点胶压力;调节“止动“高度;换胶,选择合适粘度的胶种;贴片胶从冰箱中取出后应恢复到室温(约4h)再投入生产;调整点胶量。
2、胶嘴堵塞
胶嘴出胶量偏少或没有胶点出来。产生原因一般是针孔内未完全洁洗干净;贴片胶中混入杂质,有堵孔现象;不相溶的胶水相混合。
解决方法:换清洁的针头;换质量好的贴片胶;贴片胶牌号不应搞错
3、空打
只有点胶动作,却无出胶量。产生原因是贴片胶混入气泡;胶嘴堵塞
解决方法:注射筒中的胶应进行脱气泡处理(特别是自己装的胶);更换胶嘴
4、元器件移位
片胶固化后元器件移位,严重时元器件引脚不在焊盘上。产生原因是贴片胶出胶量不均匀,例如片式元件两点胶水中一个多一个少;贴片时元件移位或贴片胶初粘力低;点胶后PCB放置时间太长胶水半固化。
解决方法: 检查胶嘴是否有堵塞,排除出胶不均匀现象;调整贴片机工作状态;换胶水;点胶后PCB放置时间不应太长(短于4h)。
5、波峰焊后会掉片
固化后元器件粘结强度不够,低于规定值,有时用手触摸会出现掉片。产生原因是因为固化工艺参数不到位,特别是温度不够,元件尺寸过大,吸热量大,光固化灯老化;胶水量不够;元件/PCB有污染。
解决办法: 调整固化曲线,特别是提高固化温度,通常热固化胶的峰值固化温度为150℃左右,达不到峰值温度易引起掉片。对光固胶来说,应观察光固化灯是否老化,灯管是否有发黑现象;胶水的数量和元件/PCB是否有污染都是应该考虑的问题。
6、固化后元件引脚上浮/移位
这种故障的现象是固化后元件引脚浮起来或移位,波峰后锡料会进入盘下,严重时会出现短路、开路。产生原因主要是贴片胶不均匀、贴片胶量过多或贴片时元件偏移。

焊锡膏印刷与贴片质量分析
焊锡膏印刷质量分析
由焊锡膏印刷不良导致的品质问题常见有以下几种:
-
焊锡膏不足(局部缺少甚至整体缺少)将导致焊接后元器件焊点锡量不足、元器件开路、元器件偏位、元器件竖立.
-
焊锡膏粘连将导致焊接后电路短接、元器件偏位.
-
焊锡膏印刷整体偏位将导致整板元器件焊接不良,如少锡、开路、偏位、竖件等.
-
焊锡膏拉尖易引起焊接后短路.

1. 导致焊锡膏不足的主要因素
-
印刷机工作时,没有及时补充添加焊锡膏.
-
焊锡膏品质异常,其中混有硬块等异物.
-
以前未用完的焊锡膏已经过期,被二次使用.
-
电路板质量问题,焊盘上有不显眼的覆盖物,例如被印到焊盘上的阻焊剂(绿油).
-
电路板在印刷机内的固定夹持松动.
-
焊锡膏漏印网板薄厚不均匀.
-
焊锡膏漏印网板或电路板上有污染物(如PCB包装物、网板擦拭纸、环境空气中漂浮的异物等).
-
焊锡膏刮刀损坏、网板损坏.
-
焊锡膏刮刀的压力、角度、速度以及脱模速度等设备参数设置不合适.
-
焊锡膏印刷完成后,因为人为因素不慎被碰掉。
2、导致焊锡膏粘连的主要因素
-
电路板的设计缺陷,焊盘间距过小。
-
网板问题,镂孔位置不正。
-
网板未擦拭洁净。
-
网板问题使焊锡膏脱落不良。
-
焊锡育性能不良,粘度、坍塌不合格。
-
电路板在印刷机内的固定夹持松动。
-
焊锡膏刮刀的压力、角度、速度以及脱模速度等设备参数设置不合适。
-
焊锡育印刷完成后,因为人为因素被挤压粘连。
3、导致焊锡膏印刷整体偏位的主要因素
-
电路板上的定位基准点不清晰。
-
电路板上的定位基准点与网板的基准点没有对正。
-
电路板在印刷机内的固定夹持松动,定位顶针不到位。
-
印刷机的光学定位系统故障。
-
焊锡育漏印网板开孔与电路板的设计文件不符合。
4、导致印刷焊锡膏拉尖的主要因素
-
焊锡膏粘度等性能参数有问题。
-
电路板与漏印网板分离时的脱模参数设定有问题。
-
漏印网板镂孔的孔壁有毛刺。
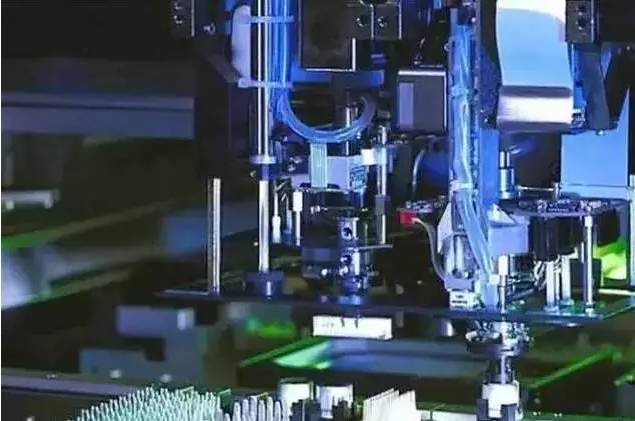
影响再流焊品质的因素 焊锡膏的影响因素 再流焊的品质受诸多因素的影响,最重要的因素是再流焊炉的温度曲线及焊锡膏的成分参数,现在常用的高性能再流焊炉,已能比较方便地精确控制、调整温度曲线。相比之下,在高密度与小型化的趋势中,焊锡膏的印刷就成了再流焊质量的关键。 焊锡膏合金粉末的颗粒形状与窄间距器件的焊接质量有关,焊锡膏的粘度与成分也必须选用适当。另外,焊锡膏一般冷藏储存,取用时待恢复到室温后,才能开盖,要特别注意避免因温差使焊锡膏混入水汽,需要时用搅拌机搅匀焊锡膏。 焊接设备的影响 有时,再流焊设备的传送带震动过大也是影响焊接质量的因素之一。 再流焊工艺的影响 在排除了焊锡膏印刷工艺与贴片工艺的品质异常之后,再流焊工艺本身也会导致以下品质异常: -
冷焊通常是再流焊温度偏低或再流区的时间不足.
-
锡珠预热区温度爬升速度过快(一般要求,温度上升的斜率小于3度每秒).
-
连锡电路板或元器件受潮,含水分过多易引起锡爆产生连锡.
-
裂纹一般是降温区温度下降过快(一般有铅焊接的温度下降斜率小于4度每秒).
声明:文章来源网络,如侵删。
-









