HDI 板的组装封装与镀覆孔技术解析
- 1+n+1 结构:适用于基础级 HDI 需求,在消费电子、智能穿戴设备等产品中应用广泛。
- 2+n+2 结构:适配中高复杂度设计,如手机主板、通信模块等精密电子产品。
- 3+n+3 结构:专为超高密度设计打造,可满足高端服务器、5G 基站等对性能要求严苛的设备需求。
硬之城支持样板(1+n+1、2+n+2、3+n+3)和批量生产(1+n+1、2+n+2),满足不同阶段的研发与制造需求。
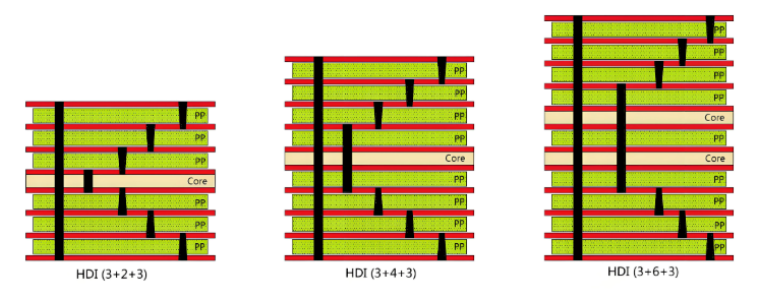
HDI板的组装封装涉及高精度贴片(SMT)、BGA封装、芯片级封装(CSP)等,其核心挑战在于:
微细间距元件的贴装:如01005元件、0.3mm间距BGA。
多层堆叠的散热与应力管理。
高可靠性焊接工艺:如激光焊接、真空回流焊
硬之城采用高精度SMT设备+3D SPI/AOI检测,确保HDI板的组装良率和长期可靠性。
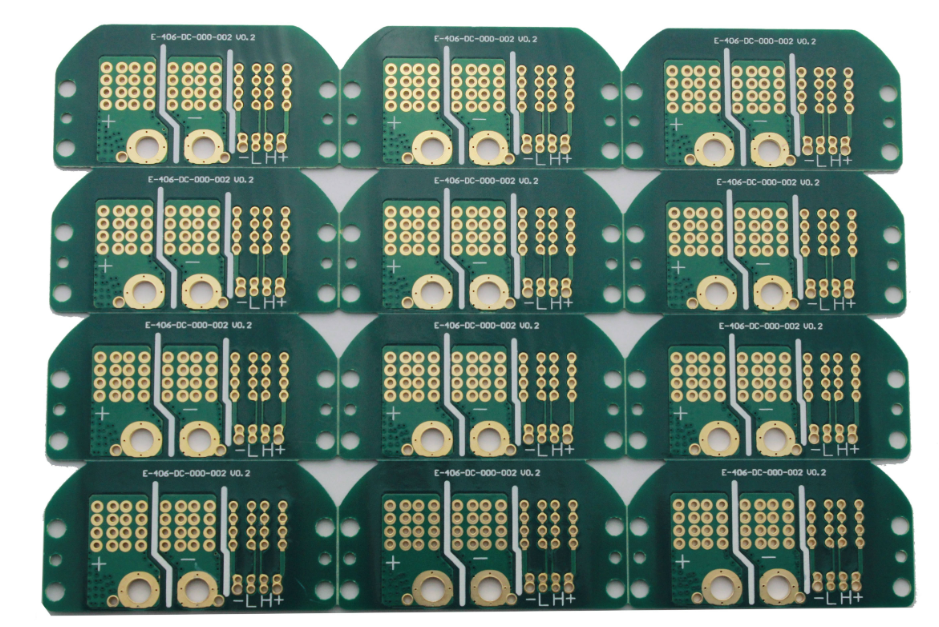
HDI板的关键在于微孔互连,主要涉及:
机械钻孔(PTH):适用于通孔,孔径通常≥0.15mm。
激光钻孔(盲埋孔):可实现0.05-0.1mm超小孔径,用于高密度布线。
电镀填孔技术:确保孔内铜厚均匀,提高导电性和机械强度。
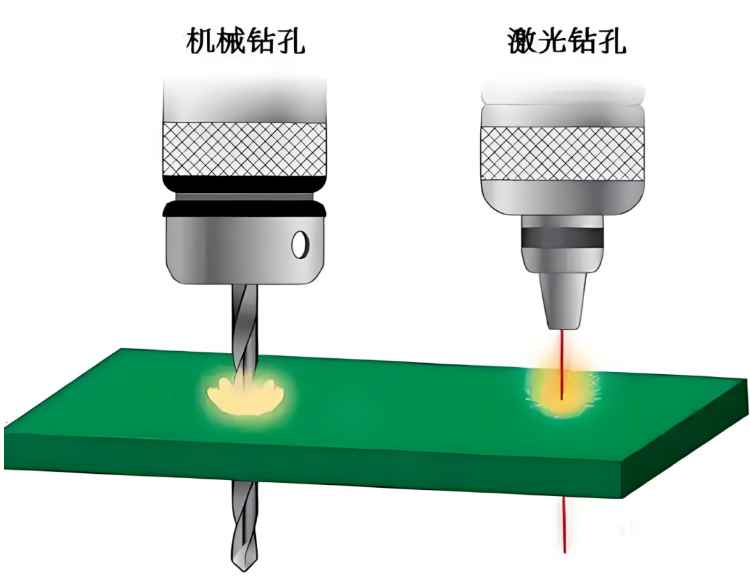
HDI板的组装封装与镀覆孔技术直接影响产品的性能和可靠性。硬之城凭借成熟的HDI工艺和丰富的行业经验,为客户提供高性价比的HDI解决方案。无论是研发打样还是批量生产,我们都能满足您的需求!









